薄膜计量
基于模型的高级分析(MBA)是 ZYGO 最先进的基于相干扫描干涉法(CSI)的薄膜测量技术,它的工作原理是将样品薄膜叠层的理论模型与轮廓仪看到的实际测量信号进行比较。这项专利技术可在几秒钟内同时测量 50-2000 nm 单层薄膜的形貌、厚度和基底形貌。除了表征薄膜外,MBA 技术还可以通过调整在一些情况下发生的反射相变(PCOR)来测量不同材料的真实形貌。
CSI 的挑战和机遇
CSI 可以在许多表面上提供非接触式的区域形貌图。如果这些表面是透明的,一部分入射光会穿透表面,并可能从下一个界面反射出来。对于比 CSI 信号大小厚得多的材料,要将上表面和下表面基底的反射分开是比较简单的。

以下表面的典型 CSI 信号:(a) 裸露表面(无膜);(b) 厚膜(远超过 1 µm),表面和基底的信号被很好地分开;(c) 亚微米薄膜,表面和基底的信号被混在一起。
然而,当透明材料的厚度降低到一微米以下时,信号开始重叠。传统的信号分析方法无法应对这种情况,但在解包计算包含关于薄膜及其所沉积基底的信息的信号时,我们看到了一个明显的机会。
基于模型的 CSI
ZYGO 基于模型的分析方法解决了这个问题。用户被要求定义他们的薄膜叠层的光学特性(折射率 n 和吸收系数 k)。使用系统级校准信息,可以对测量进行模拟,为所述薄膜的厚度范围创建一个可能的 CSI 信号库。然后,将测量结果与每个像素处的信号库进行比较,创建一个精确的薄膜厚度图,以及上、下表面形貌图。
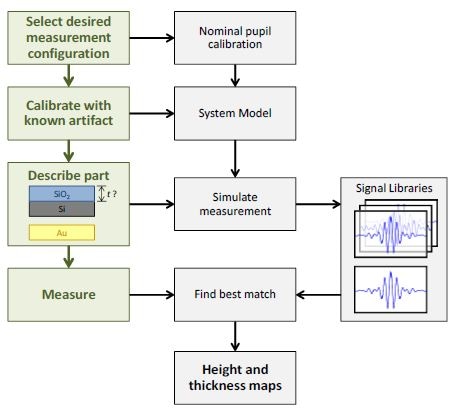
所提出方法的测量流程。用户执行的步骤以绿色显示。
这种测量方法保持了非接触式、区域 CSI 计量的所有主要优势。
吞吐量高,全场采集的测量时间不到 10 秒,即使是厚度搜索范围超过一微米的测量也是如此。
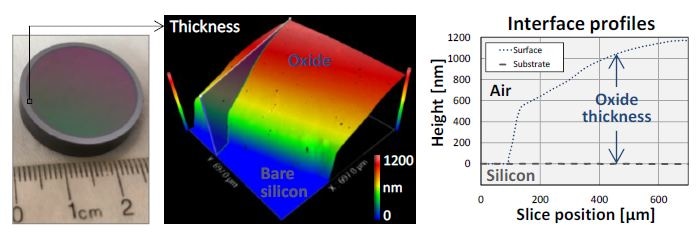
灵活、精确,支持许多放大倍率,与全套 ZYGO 物镜兼容。在 2 个数量级的放大倍率上,膜厚值稳定在纳米级。

所有 Nexview 系统都可以使用基于模型的分析。
